关键词:芯片 良率分析 晶圆图 质量管理 JMP Minitab
半导体芯片的生产,简单来讲,是将电路通过各种复杂的物理化学方法制作到晶圆上,在生产的最后阶段会进行不同电性功能的测试以确保产品的功能性,而利用这些测试结果再结合晶圆的形状所产生的图形就是晶圆图(Wafer Map)。晶圆图是以芯片(Die)为单位的,将测试完成的结果用不同颜色、形状或代码标示在各个芯片的位置上。
半导体业内人士都知道:晶圆图是提供追溯产品发生异常原因的重要线索,通过晶圆图的空间分布情况及其模型分析,可以找出可能发生低良率的原因(例如有问题的机台或异常的制程步骤等)。所以,哪怕当前的良率较高,每个工厂也会记录每片晶圆经过测试后产生的晶圆图,以作为工作报告的必备内容或者事故诊断的重要依据。
虽然现在的不少半导体加工设备本身就提供了一些制作晶圆图的功能,但基本上都是些简单且固定的模式,工程师们稍微有些新想法、新要求就无法实现了。我们老板想省钱,前两年想请IT部门配合用Excel中的VBA开发一个具有定制化功能的晶圆图分析软件,但实施起来遇到很多困难,最后这个项目也就不了了之了。上个月参加了JMP中国区的技术专家到我们公司做的“数据可视化”培训,意外地发现用JMP可以轻松制作出适合我们实际需要的晶圆图。
据我所知,JMP在半导体领域相当普及,无论是搞研发、设计、生产、工艺、质量还是六西格玛的,都会用得到它(这个领域好像Minitab用得不多-题外话)。用JMP软件绘制晶圆图的方法有好几种,最方便的是用“图形生成器(Graph Builder)”,将数据拖入JMP图形生成器的制图区域即可得到,其中用颜色来表示不同的测试结果。
也可以不用颜色来区分不同的测试结果,而是直接用数字或英文字母来表示。下图就是一张用0代表合格、用1~7分别代表七种不同缺陷的晶圆图。够直观的吧?只要有规律地修改JMP数据表中各行的“行标记”就行了。
实际工作中有时候需要制作上面两种Bin Wafer Map之外,有时候还需要制作Parametric Wafer Map。它与前者的主要区别是需要在图形上增加等高线图Contour Plot,这在JMP软件中也很方便。下面的这张Parametric Wafer Map也是用JMP的“图形生成器(Graph Builder)”完成的,从中可以直观地发现连续型测量值的变化规律,帮助工程师判断制程变异趋势。
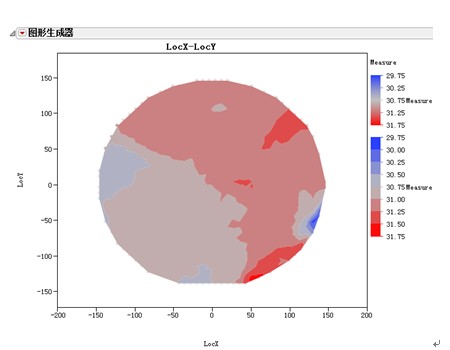
以前我一直有个想法:传统的Wafer Map都是以二维平面展现三维数据的,能不能直接就用三维空间来展现,效果会怎么样?但一直没有找到合适的工具来尝试。最近用JMP培训老师教的“三维散点图(Scatterplot 3D)”试了一下,图形(见下图)效果如下,还能360度任意旋转,挺好玩的。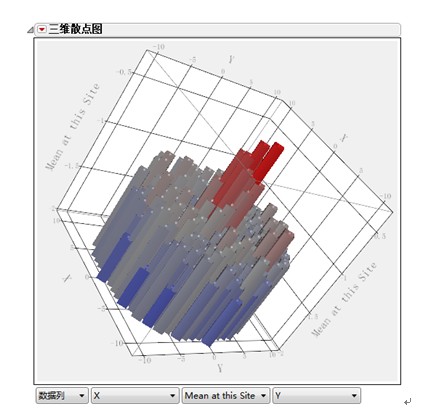
其实,最让我感兴趣的还有用JMP软件自带的编程语言JSL(JMP Scripting Language)把JMP的图形生成器、地图、数据过滤器、图形与数据源的